芯片失效分析
理论上研究可行的产品实际生产出来在使用中可能会与预期有所差距,芯片也是如此。芯片(IC)在研发设计、生产制造过程中可能会出现一些错误和问题,使芯片不能达到预期的功能。这类芯片我们称之为失效芯片。对于失效芯片进行分析,研究产生失效问题的原因,针对这些原因探讨解决办法就是芯片失效分析。
失效分析属于芯片反向工程开发范畴。欣创微芯片失效分析主要提供封装去除、层次去除、芯片染色、芯片拍照、大图彩印、电路修改等技术服务项目。
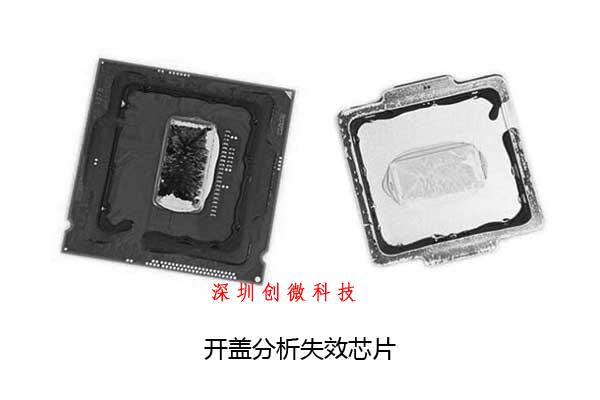
公司专门设立有集成电路失效分析实验室,配备了国外先进的等离子蚀刻机(RIE)、光学显微镜、电子显微镜(SEM)和聚焦离子束机(FIB)等设备,满足各项失效分析服务的要求。公司拥有一套完善的失效分析流程及多种分析手段,全方位保证工程质量及项目文件的准确无误。
1.失效分析是确定芯片失效机理的必要手段。
2.失效分析为有效的故障诊断提供了必要的信息。
3.失效分析为设计工程师不断改进或者修复芯片的设计,使之与设计规范更加吻合提供必要的反馈信息。
4.失效分析可以评估不同测试向量的有效性,为生产测试提供必要的补充,为验证测试流程优化提供必要的信息基础。
1、X-Ray 无损侦测,可用于检测:
a.IC封装中的各种缺陷如层剥离、爆裂、空洞以及打线的完整性
b.PCB制程中可能存在的缺陷如对齐不良或桥接
c.开路、短路或不正常连接的缺陷
d.封装中的锡球完整性
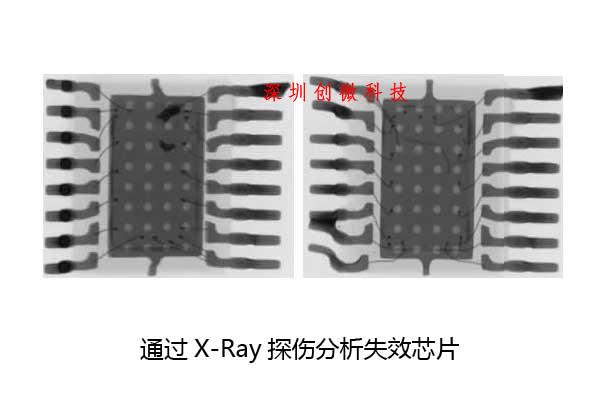
2、SAT超声波探伤仪/扫描超声波显微镜,可对IC封装内部结构进行非破坏性检测, 有效检出因水气或热能所造成的各种破坏如﹕
a.晶元面脱层
b.锡球、晶元或填胶中的裂缝
c.封装材料内部的气孔
d.各种孔洞如晶元接合面、锡球、填胶等处的孔洞
3、SEM扫描电镜/EDX能量弥散X光仪
可用于材料结构分析/缺陷观察,元素组成常规微区分析,精确测量元器件尺寸。
4、三种常用漏电流路径分析手段:EMMI微光显微镜/OBIRCH镭射光束诱发阻抗值变化测试/LC液晶热点侦测
EMMI微光显微镜用于侦测ESD,Latch up, I/O Leakage, junction defect, hot electrons , oxide current leakage等所造成的异常。
OBIRCH常用于芯片内部高阻抗及低阻抗分析,线路漏电路径分析.利用OBIRCH方法,可以有效地对电路中缺陷定位,如线条中的空洞、通孔下的空洞。通孔底部高阻区等;也能有效的检测短路或漏电,是发光显微技术的有力补充。
LC可侦测因ESD,EOS应力破坏导致芯片失效的具体位置。
5、Probe Station 探针台/Probing Test探针测试,可用来直接观测IC内部信号。
6、ESD/Latch-up静电放电/闩锁效用测试。
7、FIB做电路修改
FIB聚焦离子束可直接对金属线做切断、连接或跳线处理. 相对于再次流片验证, 先用FIB工具来验证线路设计的修改, 在时效和成本上具有非常明显的优势。
8、其它芯片失效分析方法
原子力显微镜AFM ,二次离子质谱 SIMS,飞行时间质谱TOF-SIMS ,透射电镜TEM,场发射电镜,场发射扫描俄歇探针, X光电子能谱XPS ,L-I-V测试系统,能量损失X光微区分析系统等多种复杂分析手段也是芯片失效分析所用到的一些方法。
一、外观检查
识别crack,burnt mark等问题,拍照。
二-非破坏性分析
主要用x-ray查看内部结构,检测IC封装中的各种缺陷如层剥离、爆裂、空洞以及打线的完整性,PCB制程中可能存在的缺陷如对齐不良或桥接,开路、短路或不正常连接的缺陷,封装中的锡球完整性。csam—查看是否存在delamination.
三、芯片开封
去除IC封胶,同时保持芯片功能的完整无损,保持 die,bond pads,bond wires乃至lead-frame不受损伤,为下一步芯片失效分析实验做准备。
四、SEM扫描电镜/EDX成分分析
包括材料结构分析/缺陷观察、元素组成常规微区分析、精确测量元器件尺寸等等。 探针测试:以微探针快捷方便地获取IC内部电信号。
五、镭射切割
以微激光束切断线路或芯片上层特定区域。
六、EMMI侦测
EMMI微光显微镜是一种效率极高的失效分错析工具,提供高灵敏度非破坏性的故障定位方式,可侦测和定位非常微弱的发光(可见光及近红外光),由此捕捉各种元件缺陷或异常所产生的漏电流可见光。

七、OBIRCH阻抗值变化测试
OBIRCH常用于芯片内部高阻抗及低阻抗分析,线路漏电路径分析。利用OBIRCH方法,可以有效地对电路中缺陷定位,如线条中的空洞、通孔下的空洞。通孔底部高阻区等,也能有效的检测短路或漏电,是发光显微技术的有力补充。
八、LG液晶热点侦测
利用液晶感测到IC漏电处分子排列重组,在显微镜下呈现出不同于其它区域的斑状影像,找寻在实际分析中困扰设计人员的漏电区域(超过10mA之故障点)。
九、定点/非定点芯片研磨
移除植于液晶驱动芯片 Pad上的金凸块, 保持Pad完好无损,以利后续分析或rebonding。
十、SAM (SAT)超声波探伤
可对IC封装内部结构进行非破坏性检测,有效检出因水气或热能所造成的各种破坏如:o晶元面脱层,o锡球、晶元或填胶中的裂缝,o封装材料内部的气孔,o各种孔洞如晶元接合面、锡球、填胶等处的孔洞。

